(Synchrotron Radiation Photo-Electron Spektroscopy)
Fotoelektrónová spektroskopia budená synchrotrónovým žiarením
Vlastnosti synchrotrónového žiarenia
Synchrotrónové žiarenie sa získava v kruhových urýchľovačoch resp. v tzv. akumulačných
prstencoch. Vyžarujú ho elektróny počas svojho urýchľovania v dôsledku síl,
ktoré na ne pôsobia v magnetických poliach. Uvoľnená energia má formu elektromagnetického
žiarenia,
ktoré frekvenčne pokrýva oblasť od tvrdého rengenového žiarenia až po infračervené.
Najvýznamnejšie vlastnosti synchrotrónového žiarenia sú predovštkým:
- spojité, široké spektrum vlnových dĺžok,
- prirodzená kolimácia žiarenia,
- vysoká intenzita,
- vysoký stupeň polarizácie,
- pulzný charakter žiarenia,
- možnosť koherencie.
Vďaka týmto vlastnostiam nachádza synchrotrónové žiarenie uplatnenie nie
len vo fyzike pevných
látok, ale aj v chémii, biológii či medicíne.
Na tejto stránke sa budeme zaoberať synchrotrónovým žiarením
ako zdrojom budiaceho žiarenia pre emisiu fotoelektrónov z povrchových vrstiev
kondenzovaných látok. Využitie fotoemitovaných elektrónov pre spektroskopické
účely je základom ultrafialovej fotoelektrónovej spektroskopie (UPS) a
rentgenovej fotoelektrónovej spektroskopie (
XPS).
Cieľom je poukázať
na výhody použitia SRPES voči bežnej metóde XPS, v ktorej sa skúmané vzorky
ožarujú rentgenovým žiarením s obmedzeným počtom vlnových dĺžok. Najčastejšie
sú dve s energiami fotónov 1253.6 eV a 1486.6 eV. Naproti tomu napríklad aparatúra
napojená na synchrotrón
Elettra v Terste
(
obr.5) umožňuje vyberať
fotóny s energiami v rozsahu 40-800eV.
Najvýznamnejšou vlastnosťou SRPES je laditeľnosť,
čiže možnosť vybrať si energiu fotónov, ktorými bude skúmaná látka exponovaná.
Voľbou vhodnej energie primárneho žiarenie môžeme do istej mieri ovplyvniť hrúbku
povrchovej vrstvy, z ktorej budeme detekovať fotoelektróny nesúce požadovanú informáciu.
Na pochopenie tejto výhody je dôležité priblížiť si pojmy
úniková hĺbka
a stredná voľná dráha pre neelastickú interakciu elektrónov .
Úniková hĺbka, stredná voľná dráha neelastickej interakcie
Pri rentgenovej fotoelektrónovej spektroskopii sa vzorky ožarujú
rentgenovým žiarením a meria sa kinetická energia uvoľnených fotoelektrónov.
Pre chemickú analýzu vzorky sú dôležité tie fotoelektróny, ktoré pri prechode k
detektoru neprekonajú žiadnu neelastickú interakciu (tým by stratili časť
pôvodnej kinetickej energie). Samotné rentgenové žiarenie preniká pomerne
hlboko pod povrch vzorky. Fotoelektróny uvoľnené z atómov vzorky vo väčších
hĺbkach musia pri prechode k detektoru prekonať väčšiu vzdialenosť,
čím rastie pravdepodobnosť neelastickej interakcie. Stredná dĺžka
trajektórie, ktorú elektrón s istou kinetickou energiou prejde bez neelastickej
interakcie, sa nazýva stredná voľná dráha pre neelastickú (nepružnú) interakciu.
Jej hodnota závisí na:
- Kinetickej energii fotoelektrónu,
- Na druhu materiálu, ktorý skúmame.
U väčšiny materiálov je však závislosť strednej
voľnej dráhy pre neelastický rozptyl na skúmanom materiále veľmi malá
v porovnaní so závislosťou na kinetickej energii.
Pri zanedbaní elastických zrážok, príspevok elektrónov z vrstvy
hrúbky dy a z hĺbky y k celkovému detekovanému prúdu
Ix,nlj klesá exponenciálne
so vzrastajúcou vzdialenosťou od povrchu:
dIx,nl=F.nx.σ
x.T.exp(-y/d)dy
V tomoto vzťahu predstavuje F tok fotónov,
nx koncentráciu emitujúcich atómov X, σx,nlj
pravdepodobnosť emisie elektrónu nlj atómu X pri interakcii s primárnym fotónom
(všeobecne závisí aj na uhle, pod akým rovinu skúmaného povrchu sledujeme),
T je faktor transmisie spektrometru.
Veličina d sa nazýva úniková
hĺbka fotoelektrónu. Je to kolmá vzdialenosť od roviny povrchu,
v ktorej sa pravdepodobnosť, toho že fotoelektrón uvoľnený
z atómu X v tejto hĺbke prejde k povrchu bez neelastickej interakcie,
rovná 1/e (36,8 %). Z toho vyplýva, že približne 95% signálu vychádza z
vrstvy y=3d. Stále však neuvažujeme elastické zrážky.
Hodnota únikovej hĺbky priamo súvisí so strednou voľnou
dráhou
λi neelastickej interkacie a závisí aj od uhla theta,
pod ktorým fotoelektrón detekujeme (
obr. 1):
d = λi cos θ

Obr.1: Úniková hĺbka d, z ktorej detekujeme
neelasticky reagujúce fotoelektróny, závisí na ich kinetickej energii a na uhle,
pod ktorým ich sledujeme.
V niektorých prípadoch možno uhlovú závislosť
únikovej hĺbky využiť na hĺbkové profilovanie skúmanej vzorky.
Lenže vo väčšine prípadov je nutné započítať aj vplyv elastických
zrážok fotoelektrónov. Tieto zrážky vedú k náhodným zmenám pôvodného smeru fotoelektrónu
a úniková hĺbka stráca jednoduchú kosínovú závislosť na uhle theta. Okrem toho
je na uhle theta závislá aj pravdepodobnosť emisie elektrónu
σx,nlj
. V takom prípade sa zavádza tzv. diferenciálny účinný prierez
(
dσx,nlj/dΩ)dΩ
, kde
dΩ je element priestorového uhlu. Preto je pre hĺbkové profilovanie výhodnejšie
meniť strednú voľnú dráhu elektrónu (pre neelastickú interakciu). Tá je daná predovšetkým
kinetickou energiou fotoelektrónu. Jej rádové hodnoty a charakter závislosti na kinetickej energii je
pre všetky látky podobný a má tvar zobrazený na
obr.2.

Obr. 2: Závislosť strednej voľnej dráhy fotoelektrónov
pre neelastickú interakciu na ich kinetickej energii v pevnej látke.
Keď sa zaujímame o elektrón emitovaný z hladiny (
nlj)
atómu X, môžeme voľbou primárneho rentgenového žiarenia meniť jeho kinetickú energiu
po uvoľnení z atómu a tým zároveň aj strednú voľnú dráhu neelastickej interakcie.
V konečnom dôsledku tak meníme hĺbku povrchovej vrstvy, z ktorej získavame signál (
obr. 3).
Obr.3: Pomocou SRPES možno meniť hrúbku povrchovej vrstvy,
z ktorej sa získava informácia.
Pravdepodobnosť fotoemisie, Cooprove minimum
Okrem nastavenia informačnej hĺbky zmenou energie dopadajúceho rentgenového,
resp. UV žiarenia, má ľaditeľnosť synchrotrónového žiarenia využitie
aj pri ďalších fyzikálnych javoch. Jedným z nich je závislosť pravdepodobnosti
emisie
σx,nlj elektrónu (
nlj) z atómu X
(tzv. účinný prierez), pri interakcii
so žiarením na energii
hf tohto žiarenia. V mnohých prípadoch sa táto závislosť
podobá priebehu znázornenému na
obr.4. Vidno v ňom pomerne výrazné minimum, označované
ako
Cooprove minimum. Poloha Cooprovho minima je rôzna pre rôzne prvky.
A práve táto vlastnosť sa vyžíva pri povrchovej analýze. Niektoré prvky majú totiž
väzbové energie tak podobné, že ich v elektrónovom spektre nejde od seba odlíšiť
a splývajú v ňom do jedného píku. Aby sa zistilo akou mierou k zmenám píku prispievajú
jednotlivé zložky, vyberie sa na expozíciu vzorky žiarenie s energiou odpovedajúcou
Cooprovmu minimu jedného z nich. Tým pádom je jeho príspevok k píku zanedbateľný
voči príspevku od druhého prvku.
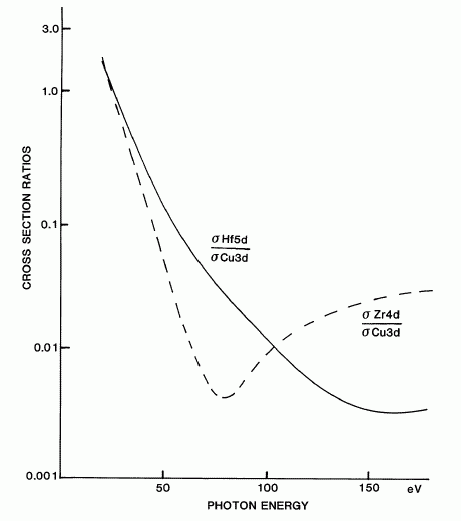
Obr.4: Teoretická závislosť pravdepodobnosti fotoionizácie hladín Hf 5p
a Zr 4d vo vzťahu k pravdepodobnosti fotoionizácie hladiny Cu 3d.
(Podľa: C.G.H. Walker, et al: The composition dependence of the electronic properties of
CuHf and CuZr amorphous metals)
Konkrétny príklad využitia SRPES
Ukážme si na konkrétnom príklade, ako sa využívajú uvedené výhody synchrotrónového
žiarenia pri analýze vlastností povrchových vrstiev. Nasledujúce údaje a grafy sú
prebraté z práce
[1] od prof. V. Matolína a spol. a ich meraní v Laboratóriu materiálového
výskumu (Material Science Beamline MSB) na synchrotróne Elettra v Terste. (
Obr.5)
Obr.5: Synchrotrón Elettra v Terste a aparatúra na MSB.
Práca sa zaoberá výskumom bimetalickej vrstvy Zr-V pripravenej magnetickým
naprašovaním. Na spektroskopickú analýzu bolo vybraté rentgenové žiarenie s energiami
600, 250 a 73eV. Pri energii 600 eV má fotoelektrón uvoľnený z hladiny O 1s
kinetickú energiu zhruba 70eV a z hladiny V 2p 88eV, čo podľa
obr.2
korešponduje s minimálnymi hodnotami strednej voľnej dráhy pre neelastickú
interackiu elektrónov. Podobne to platí pre fotoelektrón z hladiny Zr 4d pri ožarovaní
fotónmi s energiou 250 eV. Energia 73 eV odpovedá Cooprovmu minimu pre hladinu Zr 4d.
Táto hladina má ionizačnú energiu veľmi podobnú s ionizačnou energiou
hladiny V 3d. Preto sa signály od týchto dvoch hladín v spektre prekrývajú. Vďaka
Cooprovmu minimu, však možno signál od Zr 4d potlačiť, pretože v ňom je
fotoionizačný účinný prierez približne 60 krát menší ako pre V 3d.
Na
obr.6 sú zobrazené časti fotoelektrónového spektra v okolí
píku O 1s. V zázneme z bežného XPS, kde bola vzorka exponovaná primárnym žiarením s
energiou 1253,6 eV vidno, že sa intenzita sledovaného píku so vzrastajúcou teplotou výrazne mení. Naopak, v spektre
získanom pomocou SRPES k zmene intenzity takmer nedochádza. To naznačuje, že kým tesne
pod povrchom dochádza k zmenám, čo sa týka prítomnosti kyslíka, v najvrchnejšej monovrstve
kyslík zostáva a jeho chemický stav sa mení len veľmi málo (zmena chemického stavu sa
prejavuje posunom a zmenou tvaru píku).
XPS, hf = 1253 eV, 2 nm |
SRPES, hf = 600 eV, 0.5 nm |
 |
 |
Obr. 6: Eletrónové spektrum v okolí hladiny
O 1s získané metódami XPS a SRPES.
Obr.7 ilustruje to, ako sa od seba môžu líšiť tie
isté časti spektra istej vzorky, keď sa ožarujú rentgenovým žiarením
s rôznou energiou. Takéto rozdiely nám môžu mnoho napovedať o tom ako sa s
hĺbkou mení chemické zloženie povrchovej vrstvy.
SRPES, hf = 600 eV 1 nm |
SRPES, hf = 250 eV 0.5 nm |
 |
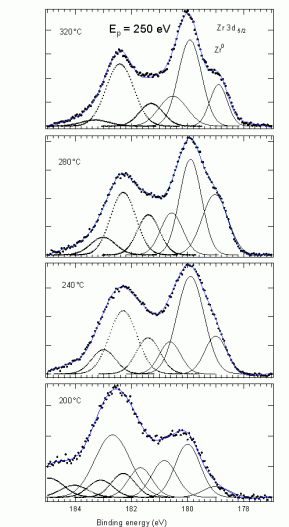 |
Obr.7: Vývoj spektra píku Zr 3d počas
postupného zohrievania vzorky.
Okrem fotoelektrónovej spektroskopie sa synchrotrónové žiarenie využíva napríklad aj pre priame štúdium štruktúry povrchov pevných látok alebo systémov substrát-adsorbát.
[1] Matolin, V; Dudr, V; Fabik, S; Chab, V; Masek, K; Matolinova,
I; Prince, KC; Skala, T; Sutara, F; Tsud, N; Veltruska, K
Activation of binary
Zr-V non-evaporable getters: synchrotron radiation photoemission study
Appl. Surf. Sci.,
243 (1-4): 106-112, 2005.