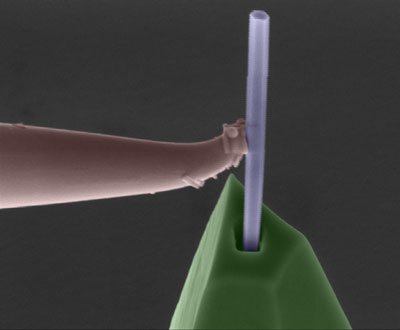
Student: Faitová Hana
Vedoucí: Doc. Mgr. Iva Matolínová, Dr.
Konzultant: Mgr. J. Lavková
Stav práce: obhájená
Abstrakt:
Mikroskopie atomárních sil (AFM) je mikroskopická technika, která se používá k trojrozměrnému zobrazování povrchů. Pracuje na principu vzájemné meziatomové přitažlivosti, kdy hrot a vzorek na sebe působí především skrze van der Waalsovu sílua detekuje se pohyb zkoumacího hrotu při jeho průchodu nad vzorkem. Základem AFM je velmi ostrý hrot, který je upevněn na ohebném nosníku (angl. cantilever). Měření lze provádět různými způsoby. Při tzv. kontaktním režimu je hrot mírně vtlačován do vzorku a následkem působících sil je nosník ohnutý. Během měření se hrot pohybuje po povrchu vzorku v pravidelném rastru (skenuje) tak, že výška druhého konce nosníku je konstantní. Je-li povrch vzorku nerovný, má nosník v různých místech vzorku různou velikost ohnutí a sledováním závislosti ohnutí na poloze na vzorku můžeme sestavit zvětšený obraz vzorku. Měření však vede k poškození hrotu, pokud by nerovnost vzorku byla příliš velká. Proto se častěji používá režim využívající zpětné vazby, tzv. režim s konstantním ohnutím (tj. na vzorek působí konstantní síla), ve kterém se v každém bodě rastru porovná současná hodnota ohnutí s přednastavenou hodnotou, a pokud se liší, nosník s hrotem se přiblíží nebo oddálí od vzorku o takovou vzdálenost, aby se hodnota ohnutí opět shodovala s přednastavenou hodnotou. V bezkontaktním režimu není mezi hrotem a vzorkem přímý mechanický kontakt, síla je velmi malá, provozuje se bezkontaktní režim tak, že je nosník rozkmitáván a místo jeho ohnutí se měří velikost amplitudy. Protože velikost amplitudy závisí na vzdálenosti mezi hrotem a vzorkem, lze sledováním změn amplitudy sestavit obraz povrchu vzorku.
Přesnost AFM je podmíněna přesností udržování polohy hrotu, přesností jeho pohybu a schopností detekce ohnutí. Pro pohybování hrotem se používají výhradně piezoelektrické skenery, které jsou schopny realizovat pohyby menší než desetina nanometru. Při zobrazování povrchu dochází často k problémům způsobeným blízkostí hrotu a vzorku, a to při silné vzájemné interakce, při zachycení či poškození hrotu, při jeho znečištění. Rovněž nenulová šířka hrotu vede k deformaci obrazu. Získaný obraz tedy velmi závisí na kvalitě použitého hrotu.
Navrhovaná bakalářská práce bude zaměřena na úpravu stávajících poškozených hrotů pro AFM mikroobráběním fokusovaným iontovým svazkem (FIB) a depozicí materiálů pomocí systému napouštění plynných prekurzorů (GIS) v řádkovacím elektronovém mikroskopu (SEM). Budou hledány vhodné pracovní postupy, kombinace materiálů, parametrů jejich depozice elektronovým a iontovým svazkem. Dostavěné hroty budou testovány v AFM při zobrazování povrchů vhodných vzorků.
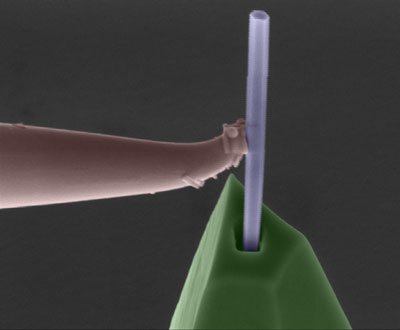
Dílčí úkoly:
1. Bibliografická rešerše.
2. Zvládnutí práce s mikroskopy AFM a SEM.
3. Testování vhodných parametrů pro mikroobrábění a depozice materiálu pomocí iontového, resp. elektronového svazku (FIB, GIS, SEM).
4. Výběr vhodných hrotů a pracovních postupů pro jejich úpravu/dosptavění v SEM.
5. Ověření funkčnosti vyrobených hrotů v AFM.
6. Vyhodnocení výsledků a sepsání bakalářské práce.
Literatura
1. Nanostructures & Nanomaterials, G. Cao, Imperial College Press, ISBN: 1-86094-415-9, London 2004.
2. Physical Principles of Electron Microscopy, R. F. Egerton, Springer, ISBN 978-0387-25800-0, Edmonton, Kanada 2007.
3. Focused Ion Beam System, edited by Nan Yao, Cambridge University Press, ISBN 978-0-521-83199-4.
4. Články v odborných časopisech podle dohody s vedoucí práce.